

一文了解SOC的DFT策略及全芯片测试的内容
EDA/IC设计
描述
01
概览篇
芯片生产过程中引入的问题
1.制程缺陷-物理瑕疵
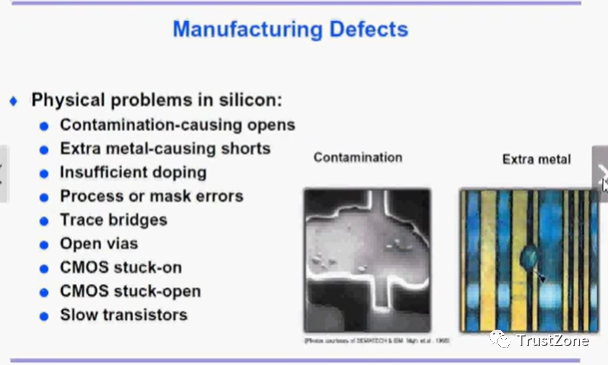
2.制程以外的缺陷

「一个非门的版图中常见的fail」
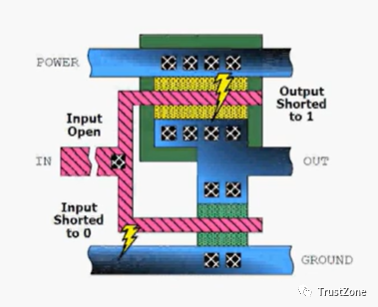
什么是DFT?为什么要做DFT?
1.Testing

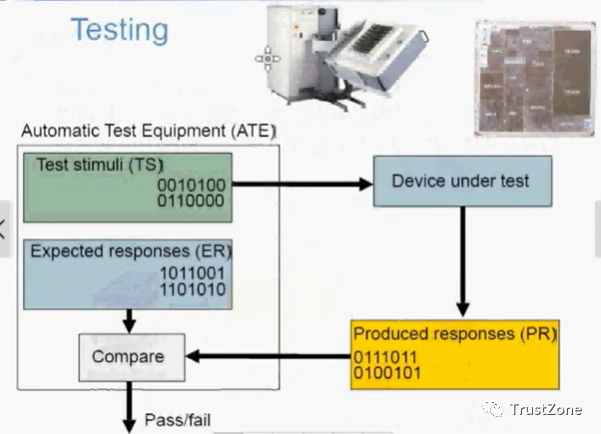
2.DFT

3.测试阶段

测试结果的评价

1.Fault Coverage

体现了DFT的质量
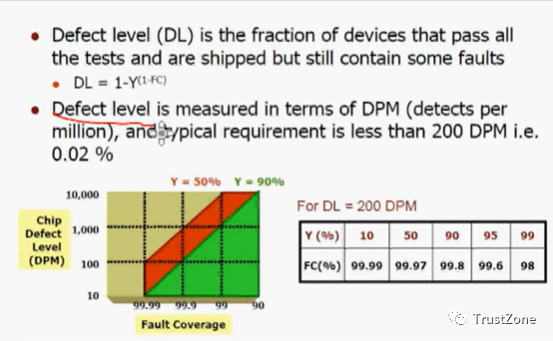
SOC的DFT策略以及全芯片测试的内容
1.SOC的DFT策略
SOC ( System on Chip)是在同一块芯片中集成了CPU、各种存储器、总线系统、专用模块以及多种l/O接口的系统级超大规模集成威廉希尔官方网站 。
由于SOC芯片的规模比较大、内部模块的类型以及来源多样,因此SOC芯片的DFT面临着诸多问题。
2.SOC涉及到的测试问题

3.SOC的全面测试

谁的风险高就先测谁,DC一般都是第一。
DC test-DC参数测试

基于SCAN的测试

BIST-内建自测试

BIST的种类与应用

LogicBIST技术的优缺点

Boundary Scan—JTAG



三种不同的协议,不同的功能,不同支持。
Boundary Scan 芯片与PAD之间连通性。FT
function pattern
ESD test
ETC.
DFT在整个IC设计中的位置

DFT与左边四个都会有不同程度的涉及。
大多数会把DFT放到Flow里面。
DFT的流程以及每步做的事情
1.A DFT reference flow
The sequence of each DFT steps can be changed
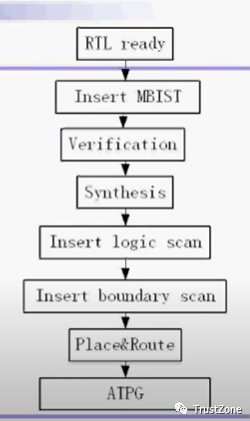
Test ltems—理论基础与工具实现

高亮的内容是DFT需要重点关注的。
2.Scan Based Test

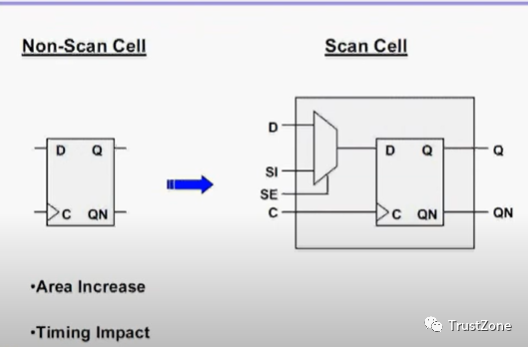
还有基于latch,但是非主流
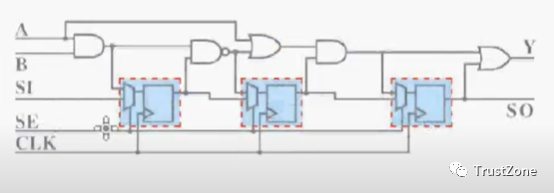
3.Fault model VS. Defect

4.Stuck-at Fault———用于低速测试
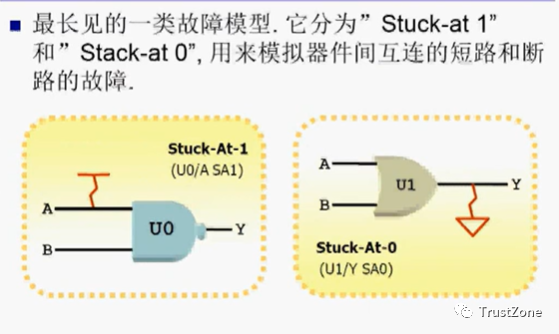
5.At-Speed Fault———用于在速测试

6.Transition Delay Fault Model

7.Path Delay model

8.D算法


9.How Scan Test works
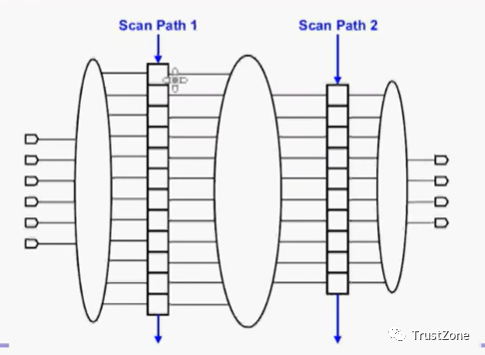
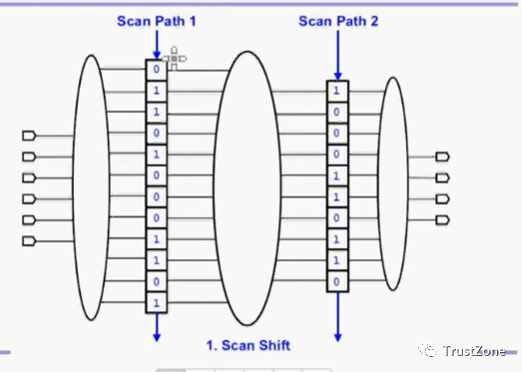
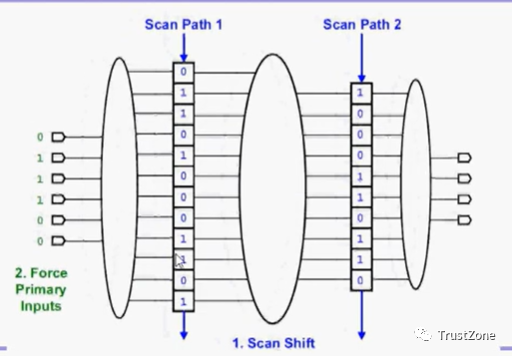
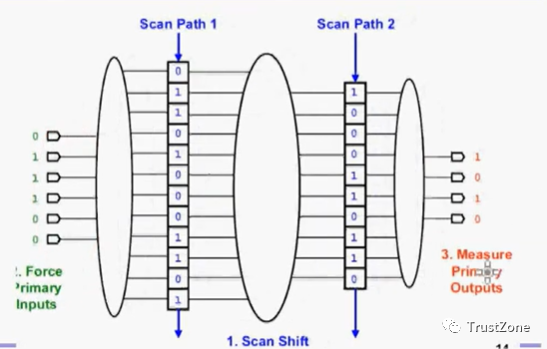

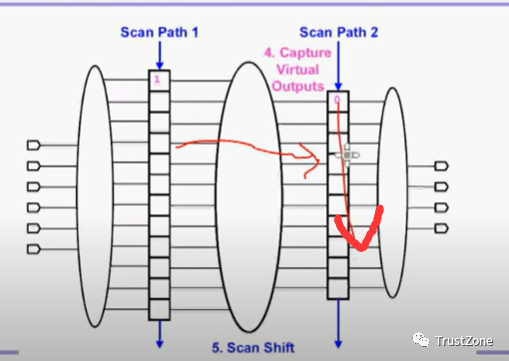

这是一个pattern
10.Transition Launch Mode
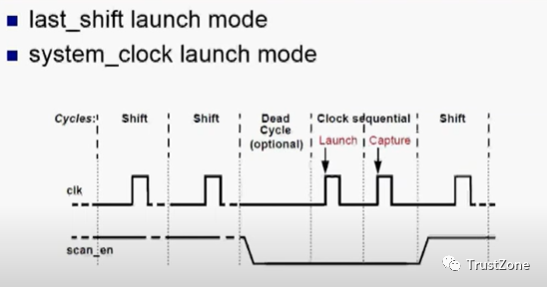

11.Full scan & Partial scan
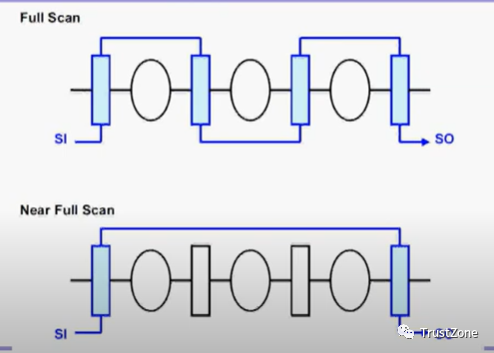
12.ATSPEED TEST & OCC
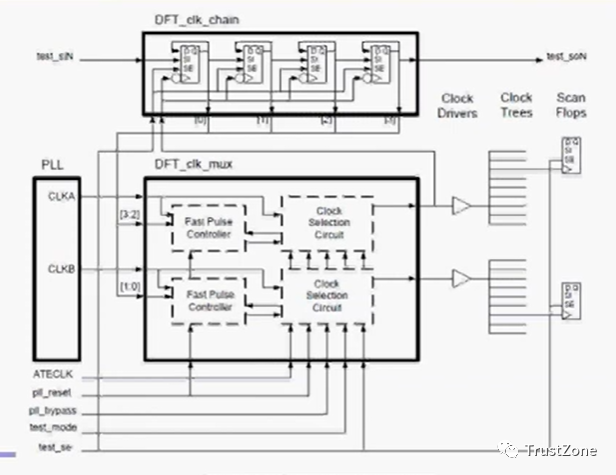
Scan chain synthesis flow——综合以后加入

Compression
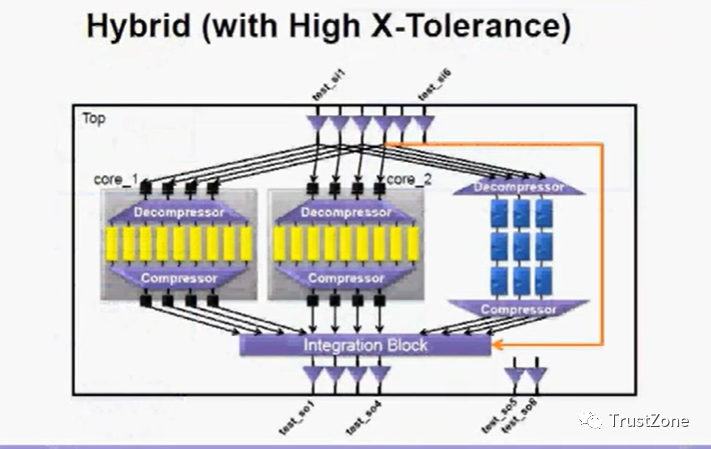
减少测试时间
13.Multi-power DFT
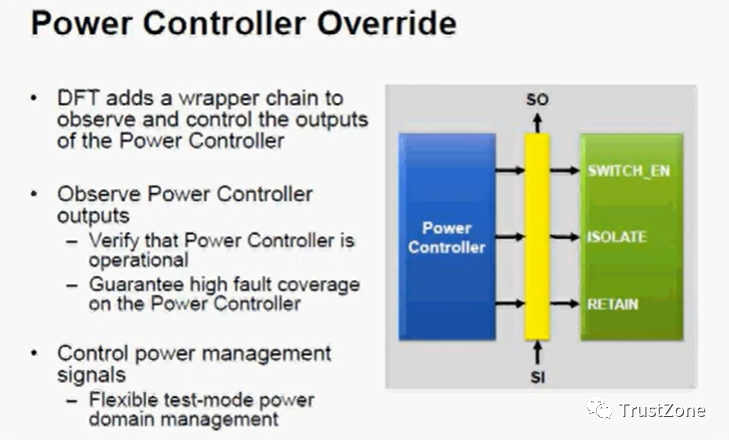
功耗
FUNC下可能会多个电压阈
但是DFT下面一般都是单个
大芯片多个威廉希尔官方网站 全电压说不定会烧测试几台:极少
ATPG-Automatic Test Pattern Generation

ATPG Focus

MBIST——综合之前或之后
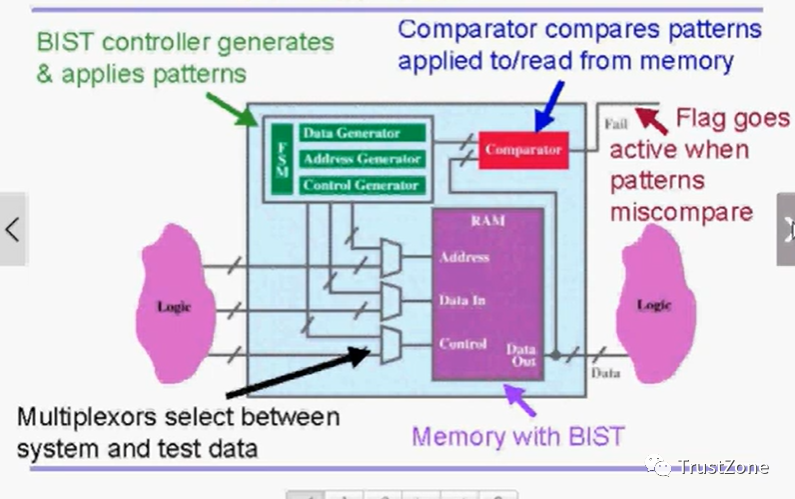
14.Compressor for ROM

15.Deal with shadow logic

16.High Speed Core MBIST

17.LBIST

18.Boundary Scan
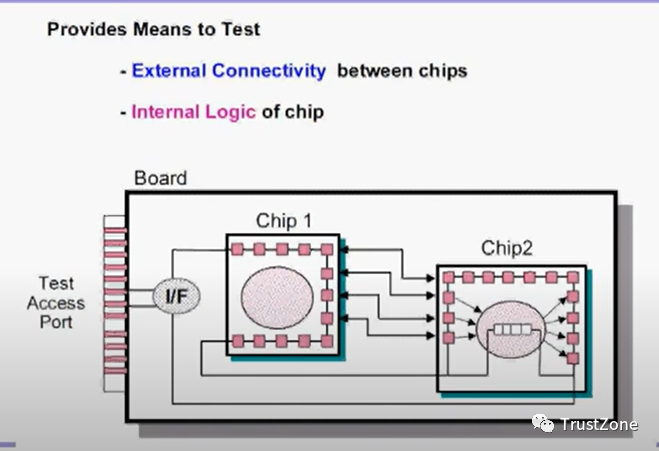
19.Boundary scan architecture

20.制程缺陷-物理瑕疵

21.TAP Ports Hookup Pin (After Synthesis)
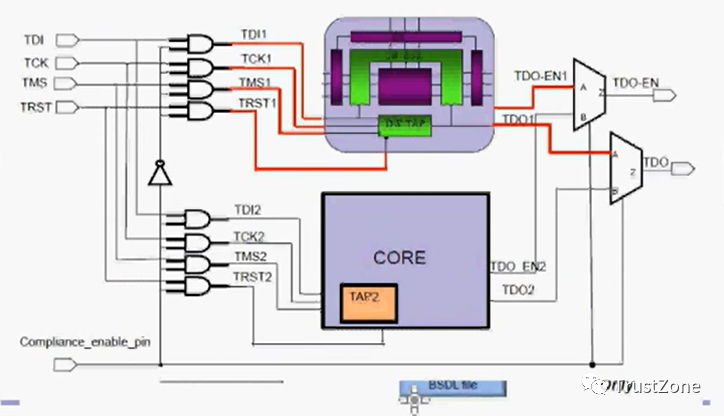
22.IDDQ

23.IDDQ defect

24.Powerfault IDDQ
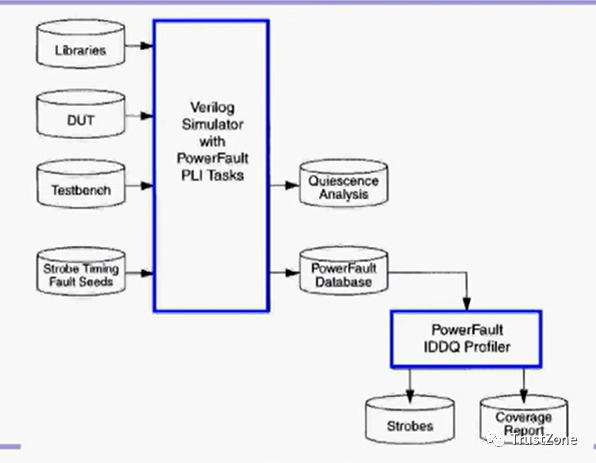
Points to be considered related to DFT

审核编辑:黄飞
-
基于扫描的DFT对芯片测试的影响有哪些?2021-05-06 0
-
什么是DFT,DFT是什么意思2010-06-07 30713
-
DFT和BIST在SoC设计中的应用2011-12-15 0
-
DFT_DFT设计概述2012-05-30 7419
-
利用PADS可测试性设计优化PCB测试点和DFT审核2019-05-14 3634
-
分层DFT技术如何实现在最大化SoC2022-11-23 1032
-
什么是DFT友好的功能ECO呢?2023-03-06 2270
-
SOC芯片的DFT策略的可测试性设计2023-04-03 7138
-
解析什么是DFT友好的功能ECO?2023-05-05 1870
-
什么是SOC?一文了解系统级芯片的优点与挑战2023-04-26 4216
-
SoC芯片设计中的可测试性设计(DFT)2023-09-02 3115
-
DFT如何产生PLL 测试pattern2023-10-30 1752
-
DFT设计—MBIST算法测试2023-12-09 4835
-
一文读懂SOC芯片2023-12-16 2193
-
pcb应变测试有多重要?一文了解!2024-02-24 1088
全部0条评论

快来发表一下你的评论吧 !

